技术突破!高导热、半烧结芯片粘接剂 满足新兴封装性能要求
当下,在移动设备、数据通信/电信、消费和汽车电子应用中,设备的功能扩展和尺寸缩小,日益推动高功率高密度器件的设计标准,如何更有效地管理由此带来的散热需求很重要。界面导热材料的使用在线路板和元器件层面解决了一定的问题;但在芯片封装层面的有效解决方案,是整体导热平衡的一个重要环节。
用于封装级烧结,同时解决了相关应用高铅焊料的环保合规问题、传统芯片粘接剂的导热性缺陷,以及传统烧结产品的可加工性缺陷。
正在申请专利的LOCTITE ABLESTIK ABP 8068T产品组合包括一系列高导热、半烧结芯片粘接剂,这些产品将有助简化流程,其绝佳的导热性能和电气性能更为可靠,为当今高功率密度设备而量身设计。
Raj Peddi
汉高全球引线键合IC封装细分市场负责人
“ 焊料素来是高导热性能和电气性能需求的主要解决方案,但由于环保法规的原因,焊料即将被市场淘汰,这推动了对替代材料的需求。由于界面接触的限制和可加工性的问题,传统的高导热芯片粘接剂和纯银烧结产品等方法也不太理想。所以汉高开发出LOCTITE ABLESTIK ABP 8068T系列半烧结芯片粘接材料,产品具有高导热性、完善可靠性和制造工艺简单的特点。”
领先优势
■ 为芯片粘接提供了一种无铅的替代方案,适用于高功率密度半导体封装;
■ 在标准加工工艺下即可使用,不像传统的银烧结材料需要高压和高温条件;
■ 由于新型芯片粘接剂形成了烧结银(Ag)和树脂的互相贯通的网络,从而与界面建立良好的接触,形成无空洞粘结层,具备优异导热性,及良好的热循环性能;
■ 适用标准芯片粘接应用,可用氮气或空气进行固化,在银、铜、镍钯金、金等多种材质的界面均有很强的粘结力。
卓越特性
■ 适用于最高达5mm x 5mm的各种尺寸芯片;
■ 绝佳导热性能:堆积导热率高达110w/m-K,在银、铜和镍钯金引线框架的封装内电阻低至约0.5K/W;
■ 广泛的可加工性:长达24小时的连续点胶时间、2小时晾置时间、4小时静置时间。
“ 对于高功率密度半导体封装而言,这正是制造商们一直在寻找的解决方案,” Peddi强调了该材料结合了性能、可靠性和可加工性。“对于那些希望找到焊料的无铅替代品(无需昂贵或复杂的加工,又能确保与传统材料同等或更优的性能)的封装专家而言,LOCTITE ABLSTIK ABP 8068T系列产品组合正好可以满足他们的需求。”
技术突破!高导热、半烧结芯片粘接剂 满足新兴封装性能要求
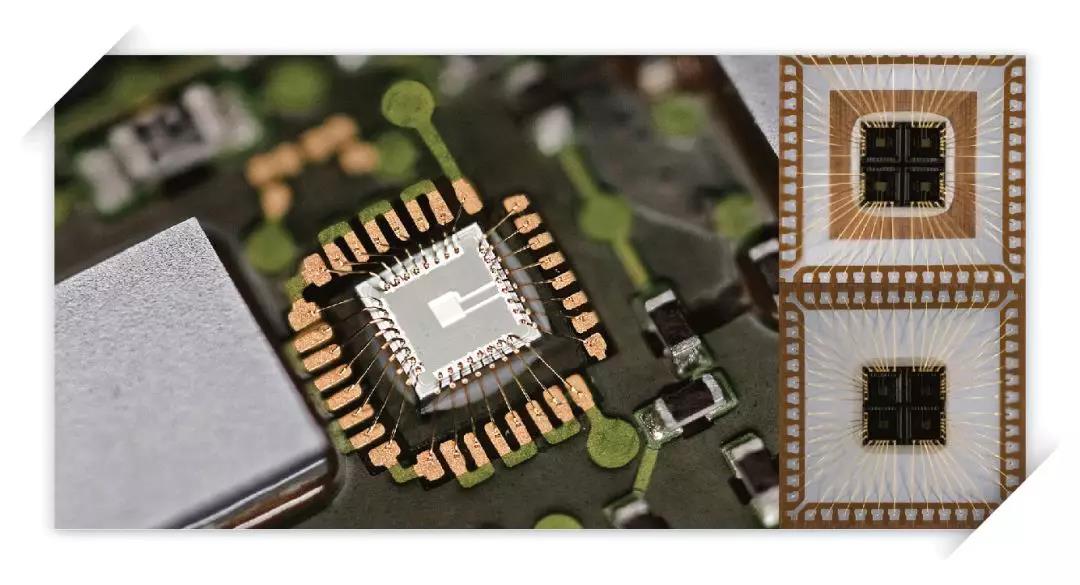
当下,在移动设备、数据通信/电信、消费和汽车电子应用中,设备的功能扩展和尺寸缩小,日益推动高功率高密度器件的设计标准,如何更有效地管理由此带来的散热需求很重要。界面导热材料的使用在线路板和元器件层面解决了一定的问题;但在芯片封装层面的有效解决方案,是整体导热平衡的一个重要环节。

用于封装级烧结,同时解决了相关应用高铅焊料的环保合规问题、传统芯片粘接剂的导热性缺陷,以及传统烧结产品的可加工性缺陷。
正在申请专利的LOCTITE ABLESTIK ABP 8068T产品组合包括一系列高导热、半烧结芯片粘接剂,这些产品将有助简化流程,其绝佳的导热性能和电气性能更为可靠,为当今高功率密度设备而量身设计。
Raj Peddi
汉高全球引线键合IC封装细分市场负责人
“ 焊料素来是高导热性能和电气性能需求的主要解决方案,但由于环保法规的原因,焊料即将被市场淘汰,这推动了对替代材料的需求。由于界面接触的限制和可加工性的问题,传统的高导热芯片粘接剂和纯银烧结产品等方法也不太理想。所以汉高开发出LOCTITE ABLESTIK ABP 8068T系列半烧结芯片粘接材料,产品具有高导热性、完善可靠性和制造工艺简单的特点。”

领先优势
■ 为芯片粘接提供了一种无铅的替代方案,适用于高功率密度半导体封装;
■ 在标准加工工艺下即可使用,不像传统的银烧结材料需要高压和高温条件;
■ 由于新型芯片粘接剂形成了烧结银(Ag)和树脂的互相贯通的网络,从而与界面建立良好的接触,形成无空洞粘结层,具备优异导热性,及良好的热循环性能;
■ 适用标准芯片粘接应用,可用氮气或空气进行固化,在银、铜、镍钯金、金等多种材质的界面均有很强的粘结力。
卓越特性
■ 适用于最高达5mm x 5mm的各种尺寸芯片;
■ 绝佳导热性能:堆积导热率高达110w/m-K,在银、铜和镍钯金引线框架的封装内电阻低至约0.5K/W;
■ 广泛的可加工性:长达24小时的连续点胶时间、2小时晾置时间、4小时静置时间。
“ 对于高功率密度半导体封装而言,这正是制造商们一直在寻找的解决方案,” Peddi强调了该材料结合了性能、可靠性和可加工性。“对于那些希望找到焊料的无铅替代品(无需昂贵或复杂的加工,又能确保与传统材料同等或更优的性能)的封装专家而言,LOCTITE ABLSTIK ABP 8068T系列产品组合正好可以满足他们的需求。”






